ハイブリッドボンディング:アドバンストパッケージングが抱える精度面の新たな課題
トランジスタの小型化が限界を迎え、超高密度の3D積層が求められるなか、次世代半導体の性能向上に貢献する技術として、アドバンストパッケージング(先進パッケージング)の一種であるハイブリッドボンディングに注目が集まっています。はんだバンプなしで銅(Cu)電極と誘電体を同時に接合するハイブリッドボンディングは、10μm以下の微細なピッチにより、半導体の小型化・省電力化・広帯域幅化を実現するなど、HBM(広帯域メモリー)やAI関連製品に欠かせません。
ハイブリッドボンディング:革新技術から基盤技術へ
ハイブリッドボンディングとは、Cu-Cu接合と誘電体-誘電体接合を同時に行うことで、はんだバンプなしで超高密度の垂直積層を可能にする技術です。現状のピッチは10µm以下ですが、高性能HBMやAIアクセラレーターに求められる小型化・省電力化・広帯域幅化のニーズに対応するため、将来的には4µm~3µm以下まで微細化が進むと予想されています。
このように、ハイブリッドボンディングは、もはや最先端の革新技術ではなく、ロジックチップ積層からチップレット製造、メモリー集積に至るまで、幅広い半導体製造工程に欠かせない基盤技術へと進化しつつあるのです。
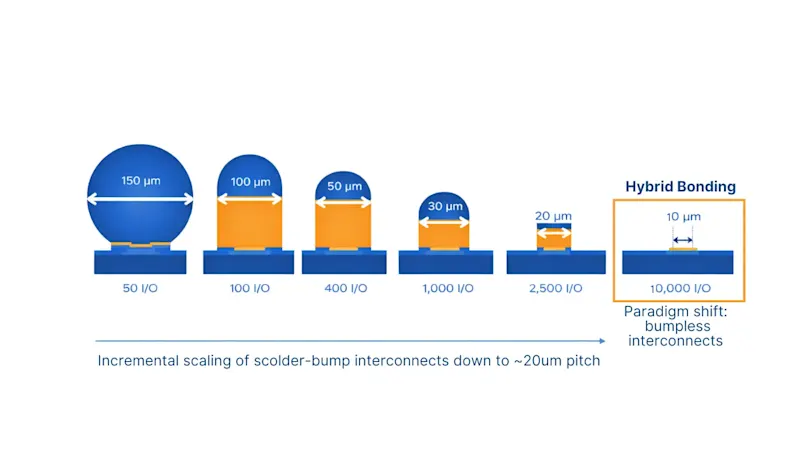
ハイブリッドボンディングが必要不可欠な理由
3つの構造的な強み
AIニーズの増大:垂直方向に大量のI/Oを配置し、1ビット当たりの消費電力を抑えることで、省電力化と広帯域幅化を実現
マイクロバンプの技術的限界:従来のバンプを上回る耐熱性・信頼性と微細なピッチにより、積層数12以上のHBM製造に対応
ロジックチップの進化:サイズ・消費電力・レイテンシーの各要件を満たし、従来の2.5Dを超える高集積化を実現するには、ダイ同士の直接接合が必要不可欠
上記の3つの強みを持つハイブリッドボンディングは、半導体の未来を切り拓く技術として期待が高まっています。
製造現場の現実:精度による差別化
大きな強みがあるとはいえ、ハイブリッドボンディングは非常に複雑な作業であるため、可用性よりも精度を重視した外観検査装置が求められます。
特にW2W(Wafer-to-Wafer)方式のハイブリッドボンディングと異なり、D2W(Die-to-Wafer)方式のハイブリッドボンディングは、温度ドリフトやウエハーの反り、レンズ歪曲収差が歩留まりに直接影響するため、誤差50nm以下の位置合わせ精度が業界標準となっています。
また、前工程の段階で表面の清浄性・平坦性を確保することも重要で、nm単位の異物・銅腐食が廃棄や電気的不良につながります。
さらに、積層数が多いほど、欠陥は発生しやすくなります。接合不良が1か所あるだけでも、複数のダイから構成される高価なパッケージを廃棄することになるため、欠陥の早期発見が欠かせません。
このほか、位置合わせ、検査、データのフィードバックなど複数の工程から構成されるハイブリッドボンディングは、各工程の精度が最終製品の性能に影響します。
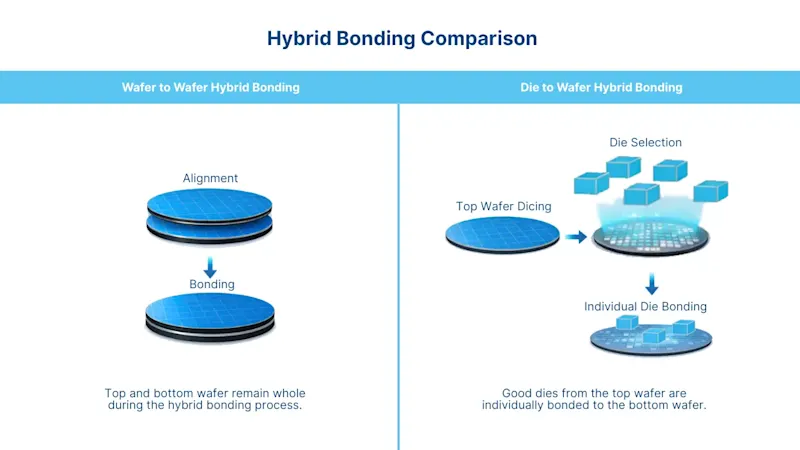
外観検査の課題:位置合わせ精度

製造公差の厳格化に伴い、これまで補助的役割であった外観検査が、歩留まりを左右する作業へと変化しつつあります。
nm単位へのピッチの微細化、ウエハー処理とパッケージングの一体化が進むなか、ハイブリッドボンディングは、半導体の後工程全体の品質に影響を及ぼすようになりました。このようななか、最終製品の性能を向上させるには、正確な位置合わせと確実な接合が欠かせません。
上記に加え、アライメントマークがシリコン材や誘電層の下に隠れたり、分解能の制約から公差判定が難しくなったりするなど、従来の撮像方法では解決できないさまざまな課題も浮上しており、十分な工程管理を行うため、細部の可視化と正確な測定が可能な外観検査装置が求められています。
外観検査装置メーカーに求められること
ハイブリッドボンディング検査装置の開発戦略
AI向けHBM、ロジック半導体、広帯域幅チップレットなど高コスト製品を優先
接合工程、撮影経路、アライメントマークの状態を総合的に考慮したうえで、事前に装置設計に反映
歩留まりを改善するため、廃棄コストの高い組立工程ではなく、上流工程でインライン検査を実施
測定機器やデータ設備を早期に拡充し、ハイブリッドボンディング検査装置の導入だけでなく、運用においても差別化を図る
ハイブリッドボンディングに向けたビジョンアプローチ
従来の外観検査装置を使用しても、シリコン表面下のアライメントマークは捉えられません。Baslerでは、ハイブリッドボンディングに対し、 「見えない=品質管理ができない」というシンプルな考えに基づいて取り組んでいます。
3つの戦略的アプローチ
高精度な位置合わせと重ね合わせ:高度な光学設計と計算補正により、数十nm~数百nm単位の幅広い測定に対応
NIRカメラとSWIRカメラによる各積層面の可視化:蛍光イメージングなどを活用し、隠れたアライメントマークを非破壊で正確に検出
拡張性に優れたインライン検査装置:製造ラインのスループットを維持したまま、ウエハーの全面撮影・ダイの欠陥検出・迅速な工程学習をサポート
このように、光学設計・計算処理・工程分析を上手く組み合わせれば、単なるカメラを高度な測定装置へと進化させることができます。
Baslerでは、超高精度な位置合わせ、シリコンの透過撮影、インライン検査に関するノウハウを駆使し、ハイブリッドボンディングに特化した次世代の検査・測定装置の開発に取り組んでいます。

100nm級の位置合わせ精度の実現に向けて
Baslerでは、ハイブリッドボンディングの位置合わせ精度を向上させるため、実際の検査環境を再現したうえで、光学限界や装置構造上の制約の検証に取り組んでいます。検証内容には、隠れたアライメントマークの検出、シミュレーションによる検出性能の分析などが含まれており、nm級の位置合わせの実現に向けて、安定性と再現性を兼ね備えた装置の設計を進めています。

ハイブリッドボンディング検査装置の開発や位置合わせに関してご相談がございましたら、ぜひお気軽にお問い合わせください。
早期の評価をサポートするため、ご要望に応じて検証資料や装置設計案、フィージビリティスタディをご提供いたします。
お問い合わせはこちら