晶圓翹曲 3D 檢測解決方案
晶圓翹曲 3D 檢測解決方案
提供可靠半導體封裝的精準平坦度量測
提供可靠半導體封裝的精準平坦度量測
翹曲是半導體封裝中的關鍵因素,會直接影響元件可靠性、組裝良率及熱效能。即使是極微小的變形,若未能適當偵測與控制,也可能導致後段製程失效。
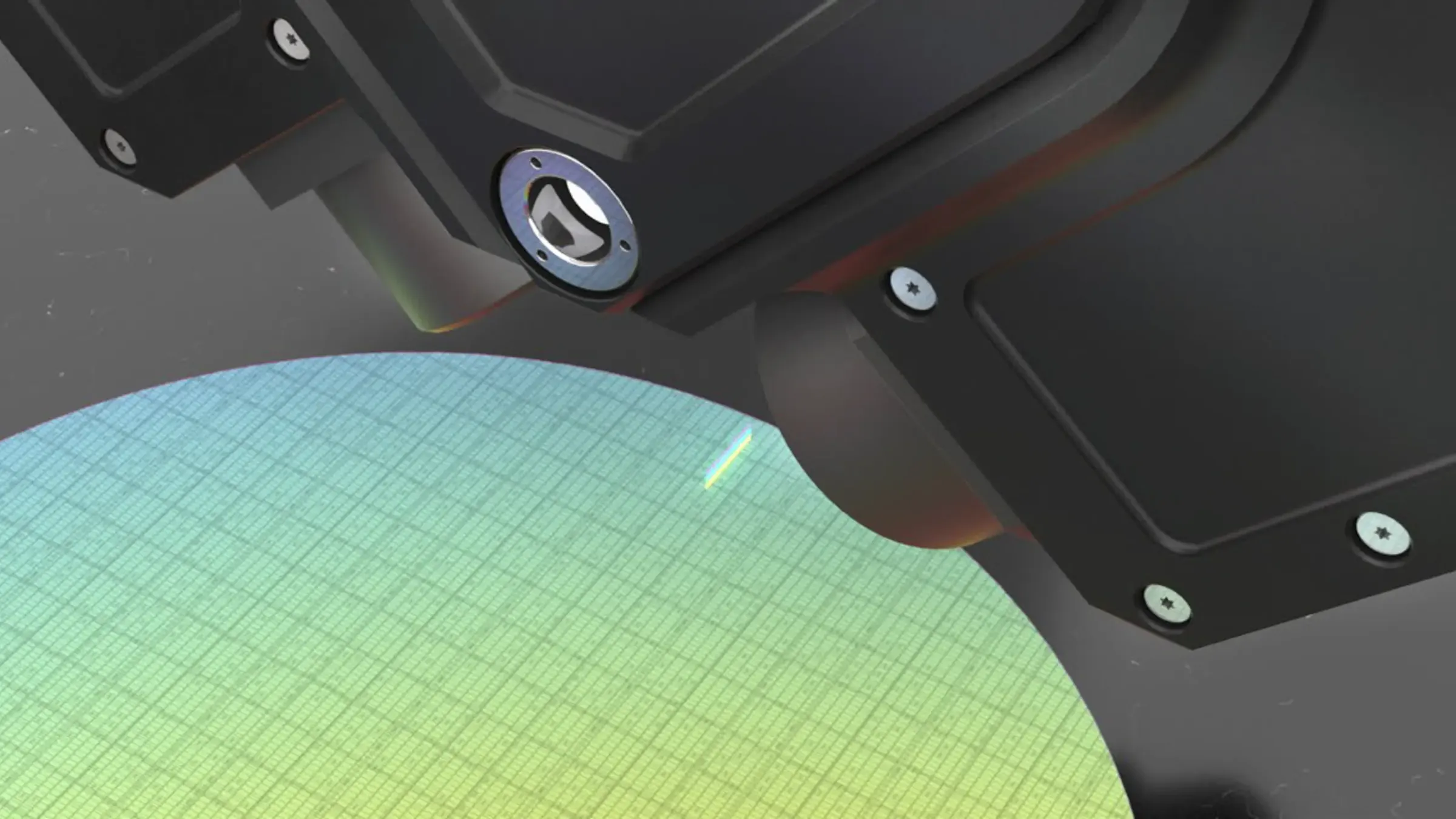
深入掌握半導體封裝翹曲量測關鍵
不同的檢測方法可提供不同層級的晶圓變形資訊。傳統方法通常僅能顯示整體表面變化,而高解析度 3D 量測則可針對整個晶圓表面的平坦度、彎曲(bow)與翹曲進行精準分析。
此類細緻的量測資訊對於準確評估變形程度及確保製程控制的有效性至關重要。
晶圓翹曲的成因與影響
翹曲通常在半導體封裝過程中產生,特別是在涉及熱循環與材料交互作用的製程階段。不同材料之間的熱膨脹係數差異,加上溫度變化,可能導致晶圓在生產過程中發生變形。
這些微小變形可能直接影響焊接品質、增加結構應力,甚至降低散熱效能,最終衝擊產品可靠度。透過掌握翹曲成因,企業可有效優化製程條件,提升良率並確保穩定的品質表現。
採用共焦技術的 3D 翹曲檢測
Gocator® 5512 智慧型 3D 線掃描共焦感光元件提供非接觸式檢測解決方案,專為高精度半導體應用而設計。
其具備 11.6 mm 的視野範圍(FOV),可精準量測晶圓平坦度與尺寸變異,同時偵測邊緣塌陷等表面缺陷。這使製造商能在製程早期辨識變形,並維持嚴格的品質控制。
該系統專為產線整合而設計,可提供穩定且高解析度的 3D 數據,有助於提升良率、確保產品品質並強化生產效率。
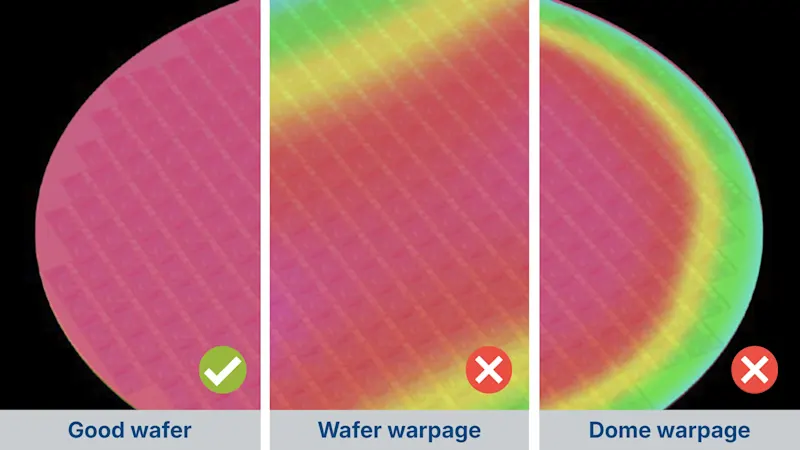
此方案所用產品
想實施類似的方案嗎?這些產品能有所助益。
