Hybrid Bonding:先進封裝中全新的精度瓶頸
混合鍵合(Hybrid Bonding)已從一項先進封裝選項,演進為推動次世代半導體發展的關鍵策略技術。隨著電晶體微縮速度趨緩,效能提升的重心已轉向超高密度的 3D 整合。透過結合介電層鍵合與銅對銅(Cu–Cu)直接互連,混合鍵合得以取消傳統焊錫凸塊,支援低於 10 µm 的互連間距,並實現更高頻寬、更低功耗以及更精巧的設計,成為 AI 與 HBM 架構不可或缺的核心技術。
混合鍵合:從技術選項邁向產業標準
混合鍵合結合介電層對介電層鍵合,以及銅對銅的直接互連,不僅消除了焊錫凸塊,更實現超高密度的垂直連結。互連間距已正式邁入 10 µm 以下,技術藍圖更指向 3 µm 至 4 µm 甚至更小的尺度。如此的連結密度,帶來更高的頻寬、更低的功耗與更小的封裝尺寸,正是 AI 加速器與先進 HBM 堆疊所高度依賴的關鍵能力。
其產業意涵已十分明確:對於先進製程系統而言,混合鍵合不再只是可選技術,而正快速成為邏輯晶片堆疊、Chiplet 架構與記憶體整合中的基本配備。
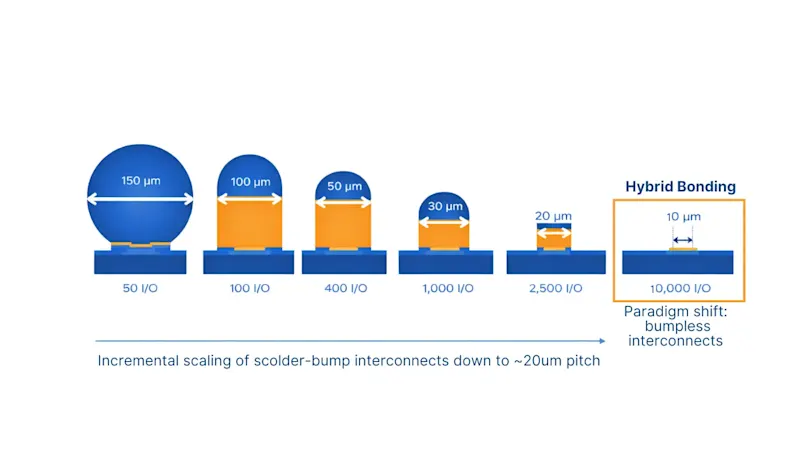
為何混合鍵合正變得無可避免
三大結構性力量正加速其導入:
AI 驅動的需求:受限於頻寬且高度敏感於能耗的 AI 工作負載,需要大規模的垂直 I/O,以及每 bit 更低的能量消耗;混合鍵合正好滿足此一關鍵需求。
微凸塊技術的極限:當 HBM 堆疊層數超過 12 層,傳統互連方式在間距、熱阻與可靠度方面,已面臨明顯瓶頸。
先進邏輯晶片的需求:為達成延遲、功耗與封裝尺寸的目標,直接的 die-to-die 連結已成為必要條件,傳統 2.5D 架構已難以因應。
綜合上述因素,混合鍵合已成為未來半導體技術藍圖中的核心基石。
製造現實:精度才是真正的關鍵差異
儘管混合鍵合的技術優勢十分明確,但其製造複雜度也大幅提升。成功與否,已不再取決於設備是否可得,而在於是否能精準執行每一個製程細節。
50 nm 以下的對位精度正迅速成為標準,特別是在 die-to-wafer 鍵合應用中。在此等尺度下,熱漂移、晶圓翹曲與光學失真都會直接影響良率。
表面潔淨度與平坦度必須接近前段製程水準。奈米等級的微粒或銅層侵蝕,都可能導致空洞形成與電性失效。
缺陷在堆疊系統中被放大。單一鍵合錯誤,即可能報廢整組高價值的多晶片堆疊,使得早期檢測與即時回饋變得至關重要。
混合鍵合並非單一製程步驟,而是一個高度耦合的生態系;最終成果,取決於對位、檢測與數據回饋之間的整體協同。
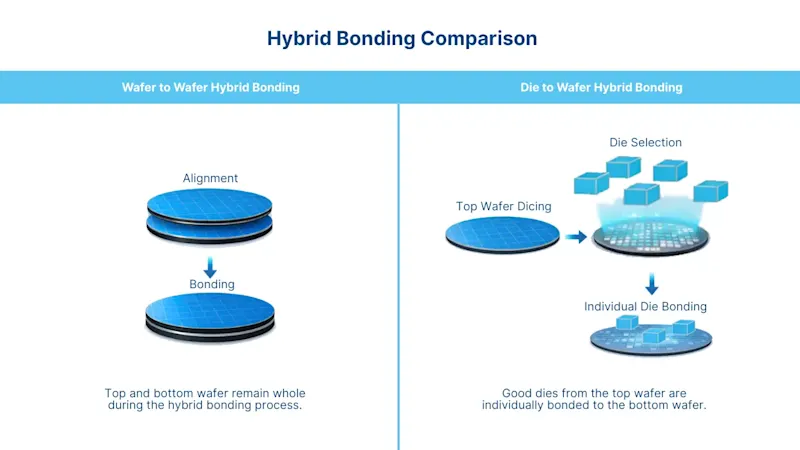
視覺挑戰:對位與檢測精度要求全面升級

隨著製造公差持續收斂,機器視覺與檢測系統已不再只是輔助角色,而是正式晉升為攸關良率的關鍵製程環節。
混合接合將成為半導體產業新的後端擴充機制。隨著晶粒接近奈米級,晶圓製程與封裝之間的區別將越來越模糊,系統效能也將越來越多地由對位精確度和接合完整性所決定。
與此同時,光學檢測正面臨根本性的挑戰。對位介面隱藏於矽材之下,對位標記被埋藏在介電層中,而可接受的公差已逼近傳統成像系統的解析極限。在缺乏足夠可視性與量測信心的情況下,製程控制將變得愈發脆弱。
製造商現在可以採取的行動
為因應混合鍵合的到來,製造商應果斷布局、提前準備:
優先聚焦高價值應用場景,例如 AI 驅動的 HBM 堆疊、邏輯對邏輯(logic-on-logic)整合,以及對頻寬高度敏感的 Chiplet 架構。
在早期即進行協同設計,同步考量鍵合製程、光學可視性與對位標記設計,而非將檢測視為事後補救的附加步驟。
將檢測前移並導入線上(inline)機制,在進入高價值組裝階段之前即攔截潛在良率損失。
及早投資具備擴展性的量測與數據基礎架構。真正的競爭優勢,來自於能否在高良率條件下穩定量產混合鍵合,而不只是「完成導入」。
以視覺為核心的混合鍵合策略
Basler 以一個簡單而關鍵的原則切入混合鍵合:看不見,就無法控制。當關鍵介面逐漸隱藏於矽材之下,傳統光學檢測技術也隨之逼近其物理極限。
為此,Basler 聚焦於三大關鍵能力:
高精度對位與疊對量測 - 透過先進光學架構與計算式校正技術,實現可從數百奈米延伸至數十奈米等級的對位與疊對量測能力,並具備量產可擴展性。
穿越堆疊的可視能力 - 結合近紅外(NIR)與短波紅外(SWIR)成像技術,並導入螢光對位概念,使埋藏於多層結構下的對位標記得以被精準檢測,無需破壞性分析。
線上、可擴展的檢測系統 - 支援全晶圓 Mapping、晶粒等級缺陷定位,以及在量產節拍下進行快速製程學習,協助製程即時優化。
在此架構下,相機已不再只是影像擷取元件,而是演進為整合光學、運算與製程智慧的量測平台。
Basler 正積極投入專為混合鍵合環境所設計的次世代光學與量測平台,整合超高精度對位能力、穿矽可視性,以及線上檢測智慧,以因應先進封裝對精度與量產控制的嚴苛需求。

邁向 100 nm 等級對位工程實踐
Basler 持續深化 Hybrid Bonding 對位核心技術,於真實製程條件下全面檢視光學極限與系統層級關鍵約束。從埋藏式對位標記可視性研究、模擬導向的可檢出性分析,到支援奈米級高穩定與高重複性的系統架構設計,我們以工程化驗證為基礎,打造可量化、可預測的 100 nm 等級對位實力。

如果您正著手進行 Hybrid Bonding 專案,或正在評估未來的對位需求,我們誠摯邀請您展開早期技術交流。
我們可分享部分模擬結果、系統架構概念與可行性研究洞察,協助您進行前期評估與技術判斷。
歡迎與我們聯繫,開啟技術討論。