使用 SWIR 相機透過對位標記,進行 1μm 精度晶圓接合檢測
隨著半導體元件的縮小和封裝複雜性日漸提升,在晶圓和晶粒接合中實現次微米等級的對位作業,難度愈來愈高。傳統的光學檢測難以處理隱藏的對位標記和近表面缺陷,進而影響產量和效能。SWIR 成像帶來了一種無損解決方案,可穿透矽和其他材料實現清晰的可視化,並實現精確對位和缺陷檢測。

精確對位:先進封裝領域日益嚴峻的挑戰
隨著半導體封裝隨著 TSV、混成黏接和 CoWoS 等技術的進步,精確的晶圓和晶粒接合變得十分重要。堆疊多個晶圓、晶粒或晶片 (如 HBM) 需要小至 1μm 的對位精度。這種規模的任何錯位,都會損害互連的完整性,降低效能並影響良率。
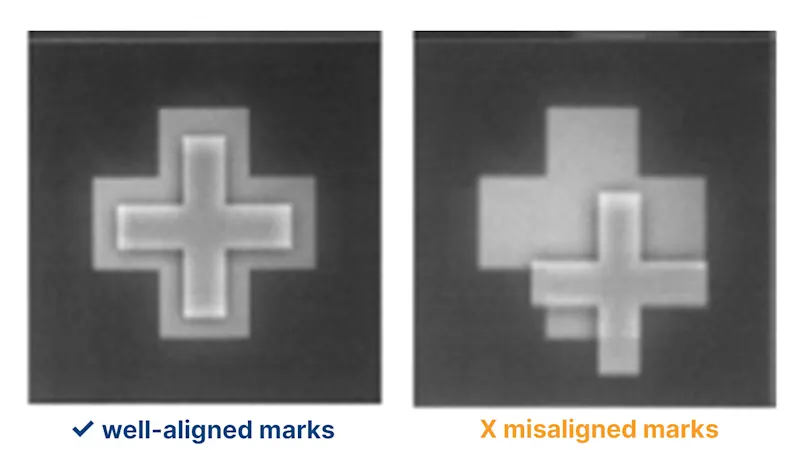
確保在晶圓和晶粒接合過程中實現精確對位和缺陷檢測,存有相當困難;這些困難可能會影響良率和元件性能,包括:
隱藏的對位標記:對位標記通常埋在矽、氧化物或接合黏著劑之下,傳統光學系統無法看見。
高對比度成像:對位標記和小缺陷可能不清晰,需要高感光度和對比度才能準確檢測出來。
用於無損對位和缺陷檢測的 SWIR 成像
SWIR (短波紅外光) 成像可以穿透矽和其他材料,在不損壞晶圓的情況下,顯現隱藏的對位標記和接合介面。然而,將 SWIR 整合到高精度半導體檢測中,需要解決下列關鍵因素:
選擇合適的感光元件來平衡靈敏度、成本和整合的複雜性
處理 InGaAs 感光元件固有的畫素缺陷
確定何時需要主動冷卻 (TEC) 、何時無需 TEC 解決方案即可
Basler SWIR 5.2MP 相機:針對半導體檢測最佳化

Basler ace 2 X visSWIR 相機為用於實驗室的高性能製冷型 SWIR 相機與用於商業和公共安全應用的低成本解決方案之間差距帶來平衡。對於高階工業用途來說,相機設計必須平衡成本效益、提供所需的精度水準,並且順暢整合到最終檢測 AOI 機器中。
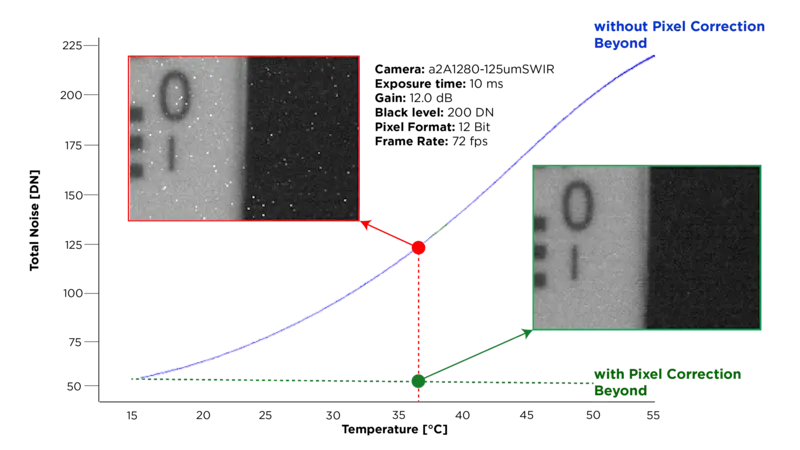
超越對位作業:SWIR 在半導體檢測中的應用
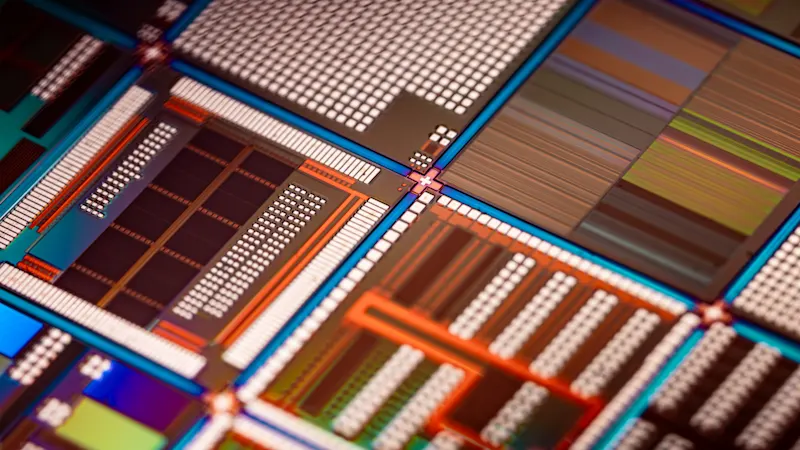
除了晶圓接合和晶粒對位之外,SWIR 成像還能強化各種半導體檢測流程,提供更深入材料穿透和高對比度缺陷檢測能力。SWIR 相機廣泛用於矽晶棒與晶圓檢測、缺陷檢測、引線接合分析和良率最佳化。SWIR 能夠穿透矽和其他材料,在多個半導體製造階段都能全面實現品質控制。
SWIR 成像:下一代 2.5D、3D 封裝
SWIR 成像能夠穿透矽和其他半導體材料,因此正在改變多種應用中的半導體檢測作業。從先進封裝中的精確對位,到缺陷檢測和良率最佳化,其影響是不可否認的。
SWIR 成像現已成為半導體 OEM 的實用解決方案,能夠為下一代 2.5D 和 3D 封裝實現精確對位和缺陷檢測。Basler 不僅提供 SWIR 相機,而且極為了解半導體檢測的各項困難,提供保證精度且不會過於複雜的工程解決方案。
聯絡我們此方案所用產品
想實施類似的方案嗎?這些產品能有所助益。



