適用於探針卡 QA 的高精度視覺
整合式自動對焦探針卡的品質保證,需要擁有微米級的精確度和穩定的影像,以便在缺陷影響晶圓測試可靠度之前,將其檢測出來。Basler 提供的視覺解決方案,具備經過驗證的相機效能、光學元件諮詢服務、整合式自動對焦,以及彈性的影像處理與分析選項,可確保一致的探針尖端檢測與長期的測試穩定性。
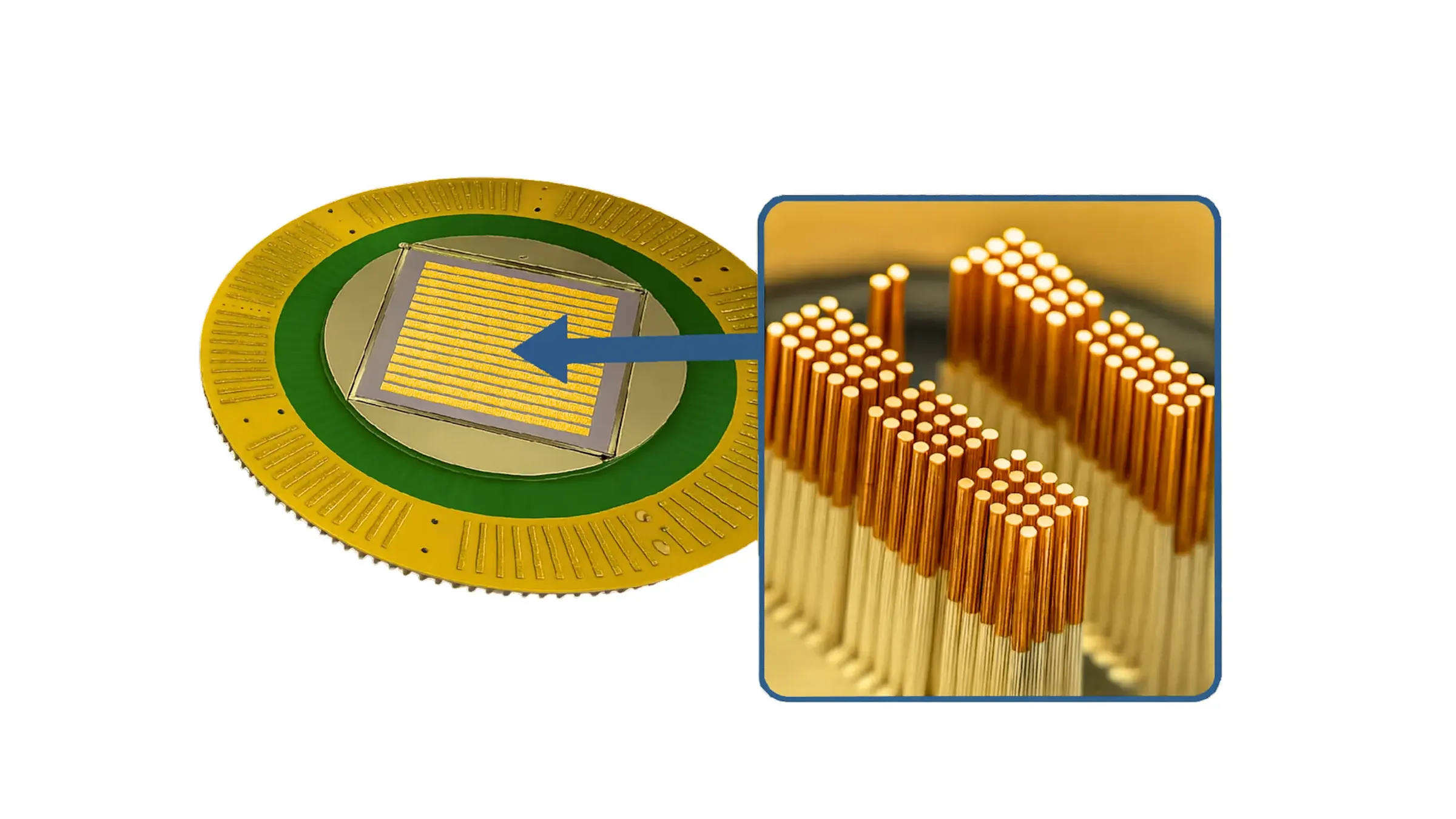
對於探針卡可靠度的要求不斷提高
隨著元件架構朝向多晶片封裝和更小凸點間距的方向發展,每根探針針尖的完整性,對已知良好晶片篩選而言變得至為重要。使用於先進晶圓探測的探針卡,可能具有數以千計的接觸點;即使是輕微的污染、彎曲或磨損,也可能影響測試的準確性,並且降低良率。
MEMS 和垂直探針卡的例行檢測,現在需要對大型反射式探針陣列進行微米級的成像。必須以高產量可靠檢測出污染堆積、氧化或彎曲的尖端,因此需要採用結合先進光源、自動對焦功能和強大演算法的視覺系統。這些解決方案可在嚴苛的 24/7 全天候生產環境中,提供工程師一致且可行的資料,以進行探針卡品質檢測。
克服探針卡缺陷偵測中的視覺障礙

XY 和 Z 的不同公差
現在,探針卡檢測通常屬於次微米任務,但不同尺寸的要求也不盡相同。在 Z 方向上,共面性和超程需要具備次微米精度,通常使用 3D 量測處理。
相比之下,XY 間距和校準屬於低微米範圍,先進的 2D 成像技術在此領域表現十分優異。在此,真正的挑戰不在於解析度本身,而在於即使遇到反射表面、光學失真以及測試場地的變化,也須確保穩定、可重複的測量結果。

照明設計與眾不同
在 25 µm 以下的精細間距中,探針尖通常使用鎢或鍍金鎢材質,而晶片襯墊則使用銅或鋁合金。這些材質會造成具挑戰性的光學條件:鎢會產生沉悶的金屬眩光,而鍍金或鎳往往造成高反射,銅質襯墊在同軸光下會發生飽和問題。傳統的亮場照明會讓污染、刮痕和探針痕跡隱藏在反射光之中。
透過策略性的照明設計,可將訊號與雜訊相互分離。同軸光可提供均勻的表面清晰度,暗場照明可顯示邊緣和碎屑;而交叉偏振則可消除鏡面反射,以獲得穩定的對比度。結合高倍率遠心光學元件與失真校正,可實現無失真的成像,帶來可靠的微米級量測結果。
與我們的工程師討論您遇到的光學挑戰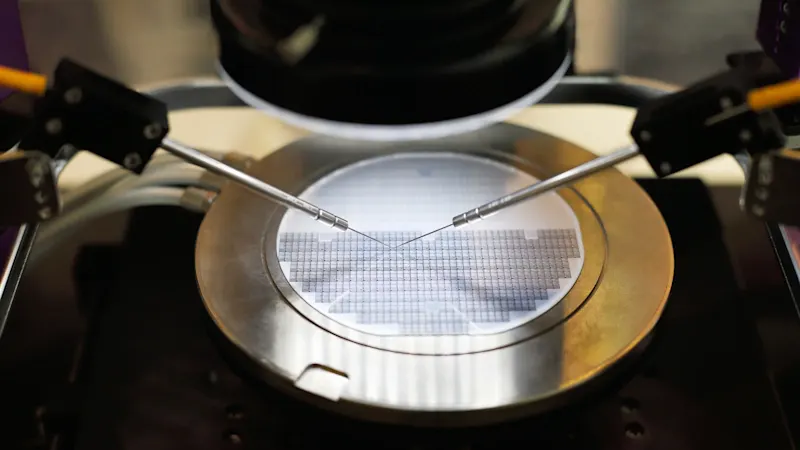
自動對焦功能,讓探針針尖保持銳利
在大型探針卡上,針尖高度的變化和探針卡的翹曲,可能會讓某些針尖離開焦平面。即使採用最佳化的照明,也很難精確測量模糊的影像。採用自動對焦技術,可在檢測過程中快速調整焦距,確保每個探針尖都保持清晰對焦。Basler 提供多種 整合式自動對焦解決方案 整合式自動對焦解決方案,包括來自不同製造商的液態鏡頭模組,以及雷射自動對焦解決方案,在維持高速檢測的同時,同時帶來清晰一致的影像。

提供可行動測量結果的演算法
一旦照明和光學元件確保了影像的清晰度,下一個挑戰,就是將影像轉換成可用的資料。
典型的方式包括 Blob 分析 透過污垢和碎屑量化、次像素邊緣偵測,以量測探針寬度和間距、並透過幾何測量 測量 來確認密集陣列的間距。這些只是軟體部分的起點。工程師還會編寫檢測任務,例如表面紋理分析,以區分氧化與污染。
對於針尖品質檢測,運算法可以使用 Basler 的pylon vTools進行量測與分析。當需要更高吞吐量或多台相機,造成 CPU 負載增加時,處理單元可使用 Basler 的 FPGA VisualApplets與 影像擷取卡 來確保即時效能。Basler 支援這兩種途徑,同步帶來靈活性與整合就緒的效能。
從事探針測試與檢驗應用的客戶,非常重視我們相機的穩定效能,與各批次之間的一致性。隨著半導體檢測邁向更為先進的節點,我們看到元件之外的需求也日益增加。Basler 身為視覺領域的強大合作夥伴,將透過視覺系統顧問、光學專業知識和成像技術,為客戶提供整個視覺領域的強力支援。

從清晰影像到可靠的探針卡品質保證
其結果是為探針卡品質保證的真正需求而量身打造的視覺解決方案:不僅具有高解析度,還具有穩定的成像、無失真的量測,以及強大的演算法,可將難以成像的反射表面轉換成可靠的資料。
想要改善探針卡 QA?與我們討論您的案例與 Basler 合作的主要優勢
可靠的效能:我們的相機可全天候穩定運作,並帶來各批次間的一致性,這對於多相機探針卡 QA 系統來說是不可或缺的。
高品質成像:Basler 相機具備高解析度、低雜訊、一致的色彩與反應,可減少校正所需心力,同時確保瑕疵檢測結果的精確。
視覺合作夥伴:除了元件之外,我們還提供光學諮詢服務、自動對焦選項,以及可客製化的演算法,以彈性的視覺合作夥伴身分來支援客戶。
此方案所用產品
想實施類似的方案嗎?這些產品能有所助益。




