하이브리드 본딩 : 첨단 패키징(Advanced packaging)에서 새롭게 부상하는 정밀도 병목 현상
하이브리드 본딩은 첨단 패키징 기술 옵션에서 차세대 반도체를 위한 전략적 핵심 기술로 진화했다. 트랜지스터 스케일링이 둔화되면서, 성능 향상은 이제 초고밀도 3D 집적에 의존하고 있다. 하이브리드 본딩은 유전체-유전체 본딩과 구리-구리(Cu-Cu) 직접 인터커넥트를 결합함으로써 솔더 범프를 제거하고, 10 µm 이하 피치를 지원하며, AI 및 HBM 아키텍처에 필수적인 고대역폭, 저전력, 소형 폼팩터를 구현한다.
하이브리드 본딩: 기술 옵션에서 산업 필수 공정으로
하이브리드 본딩은 유전체-유전체 본딩과 구리-구리 직접 인터커넥트를 결합하여 솔더 범프를 제거하고, 초고밀도 수직 인터커넥트를 가능하게 합니다. 인터커넥트 피치는 이미 10 µm 이하로 진입했으며, 로드맵상으로는 3~4 µm 및 그 이하까지를 목표로 하고 있습니다. 이러한 집적도는 더 높은 대역폭, 더 낮은 전력 소모, 더 작은 폼팩터를 가능하게 하며, 이는 AI 가속기와 첨단 HBM 스택이 요구하는 핵심 성능입니다.
의미는 명확합니다. 하이브리드 본딩은 더 이상 선단 공정에서 선택 사항이 아닙니다. 로직 스태킹, 칩렛, 메모리 집적 전반에서 기본 요구 기술로 자리 잡고 있습니다.
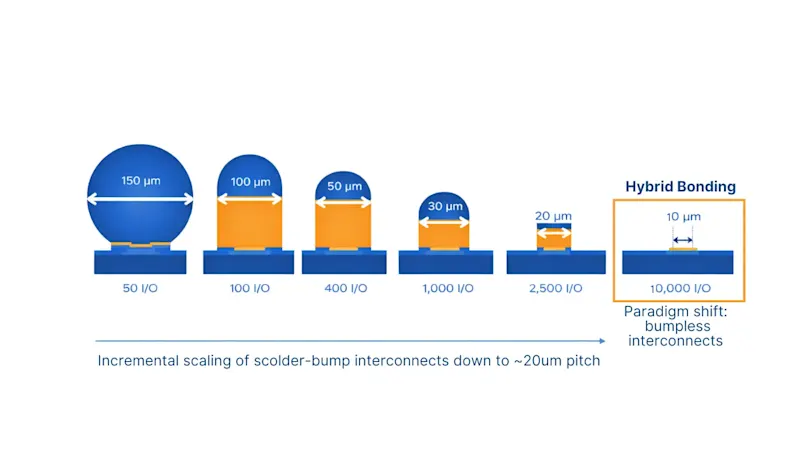
하이브리드 본딩이 불가피해지는 이유
하이브리드 본딩 도입을 가속하는 세 가지 구조적 요인 :
AI 기반 요구: 대역폭 병목과 에너지 효율에 민감한 워크로드는 대규모 수직 I/O와 비트당 에너지 소모 감소의 이점을 크게 누립니다.
마이크로 범프 기술의 한계: BM 스택이 12단을 초과하면서, 기존 인터커넥트는 피치 한계, 열 저항, 신뢰성 측면에서 구조적 과제에 직면하고 있습니다.
첨단 로직 요구: 기존 2.5D 방식으로는 지연 시간, 전력, 폼팩터 목표를 충족하기 어려우며, 이를 위해서는 다이-투-다이(Die-to-Die) 직접 연결이 필수적입니다.
이러한 요인들이 결합되면서, 하이브리드 본딩은 향후 반도체 로드맵의 핵심 기반 기술로 자리 잡고 있습니다.
제조 현실: 차별화 요소는 정밀도입니다
하이브리드 본딩이 제공하는 이점은 분명하지만, 제조 복잡도는 기존 대비 크게 증가합니다. 성공 여부는 장비 보유 여부보다는 정밀한 공정 실행 능력에 의해 좌우됩니다.
50 nm 이하 얼라인먼트 정밀도는 특히 다이-투-웨이퍼(Die-to-Wafer) 본딩에서 빠르게 표준으로 자리 잡고 있습니다. 이 수준에서는 열 드리프트, 웨이퍼 워페이지(Wafer Warpage), 광학 왜곡이 수율에 직접적인 영향을 미칩니다.
표면 청정도와 평탄도는 프론트엔드 공정 수준에 근접해야 합니다.. 나노미터 스케일의 파티클이나 구리 침식(Copper Erosion)은 보이드(Voids) 발생 및 전기적 불량을 유발할 수 있습니다.
적층 구조에서는 결함이 증폭됩니다. 단 한 번의 본딩 오류만으로도 고가의 멀티 다이 어셈블리 전체가 폐기될 수 있기 때문에, 조기 검출이 필수적입니다.
하이브리드 본딩은 단일 공정 단계가 아닙니다. 얼라인먼트, 검사, 데이터 피드백이 긴밀하게 결합된 통합 에코시스템이며, 이 요소들이 최종 성과를 결정합니다.
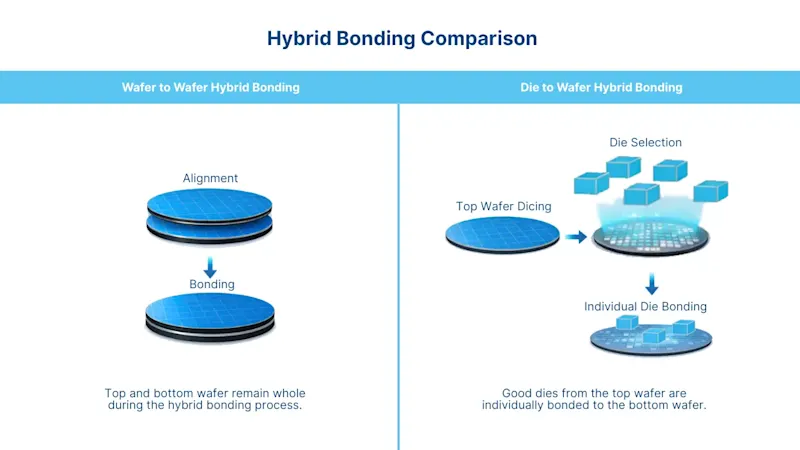
비전 과제: 얼라인먼트 및 검사 정밀도 요구사항

제조 공정 공차가 더욱 엄격해짐에 따라, 비전 및 검사 기술은 보조적 역할에서 수율을 좌우하는 핵심 기능으로 전환되고 있습니다.
하이브리드 본딩은 반도체 산업의 새로운 백엔드 스케일링 메커니즘이 될 것입니다. 피치가 나노미터 영역에 가까워짐에 따라 웨이퍼 공정과 패키징의 구분이 모호해지고 시스템 성능은 점점 더 정렬 정확도와 본딩 무결성에 의해 정의될 것입니다.
한편, 광학 검사는 근본적인 한계에 직면하고 있습니다. 얼라인먼트 인터페이스는 실리콘 하부로 가려지고, 얼라인먼트 마크는 유전체 층 아래에 매립되며, 허용 공차는 기존 이미징 시스템의 해상도 한계에 근접하고 있습니다. 충분한 가시성과 측정 신뢰성이 확보되지 않으면, 공정 제어는 점점 더 취약해집니다.
제조사가 지금 할 수 있는 일
하이브리드 본딩을 준비하는 과정에서는 보다 단호한 실행이 필요합니다.
AI 기반 HBM 스택, 로직-온-로직(Logic-on-Logic) 집적, 대역폭 민감형 칩렛과 같은 고부가가치 적용 사례를 우선적으로 선정해야 합니다.
검사를 사후 단계로 취급하지 말고, 본딩 공정, 광학 접근 방식, 얼라인먼트 마크를 초기 단계부터 공동 설계(해야 합니다..
고부가가치 어셈블리 단계 이전에 수율 손실을 방지하기 위해, 검사를 업스트림 및 인라인(Inline) 공정으로 이동해야 합니다.
확장 가능한 계측(Metrology) 및 데이터 인프라에 조기에 투자해야 합니다. 경쟁 우위는 하이브리드 본딩을 단순히 도입하는 것이 아니라, 수율 기반으로 안정적으로 운영하는 역량에서 확보됩니다.
하이브리드 본딩에 대한 비전 중심 접근 방식
Basler는 보이지 않는 것은 제어할 수 없다는 간단한 원칙으로 하이브리드 본딩에 접근합니다. 인터페이스가 실리콘 아래로 사라지면서 기존의 광학 검사는 한계에 도달했습니다.
세 가지 전략적 핵심 역량에 집중합니다.
첨단 광학 아키텍처와 연산 기반 보정을 활용하여, 수백 나노미터에서 수십 나노미터 범위까지 확장 가능한 고정밀 얼라인먼트 및 오버레이 계측을 구현합니다.
형광 얼라인먼트 개념을 포함한 NIR 및 SWIR 기반 적층 구조 가시화 기술을 적용하여, 비파괴 방식으로 유전체 하부에 매립된 얼라인먼트 마크를 정밀하게 검사할 수 있습니다.
전체 웨이퍼 매핑, 다이 단위 결함 위치 특정, 양산 처리량 수준에서의 빠른 공정 학습을 지원하는 인라인, 확장형 검사 시스템을 제공합니다.
이러한 맥락에서 카메라는 광학, 컴퓨팅 및 프로세스 인텔리전스를 통합하는 계측 플랫폼으로 진화하고 있습니다.
Basler는 초고정밀 정렬, 실리콘 관통 가시성 및 인라인 검사 인텔리전스를 결합한 하이브리드 본딩 환경을 위해 특별히 설계된 차세대 광학 및 계측 플랫폼 개발에 적극 노력하고 있습니다.

100 nm 수준 얼라인먼트를 향한 엔지니어링
Basler는 실제 공정 조건하에서 광학적 한계와 시스템 레벨 제약사항을 평가하며, 하이브리드 본딩 얼라인먼트 기술을 적극적으로 고도화하고 있습니다. 당사의 연구 범위에는 buried mark 가시성 분석, 시뮬레이션 기반 검출 가능성 평가, 그리고 안정적이고 반복 재현 가능한 나노미터 수준 얼라인먼트를 지원하기 위한 아키텍처 설계가 포함됩니다.

하이브리드 본딩 프로젝트를 진행 중이거나 향후 얼라인먼트 요구사항을 검토하고 계신다면, 초기 기술 논의를 제안드립니다.
초기 단계 평가를 지원하기 위해, 선별된 시뮬레이션 결과, 시스템 콘셉트, 그리고 타당성 분석 인사이트를 공유해 드릴 수 있습니다.
논의를 시작하려면 문의해 주십시오.